成都西野供應(yīng)日本日立HITACHI高性能FIB-SEM系統(tǒng)Ethos NX5000
如果您對該產(chǎn)品感興趣的話,可以
產(chǎn)品名稱: 成都西野供應(yīng)日本日立HITACHI高性能FIB-SEM系統(tǒng)Ethos NX5000
產(chǎn)品型號: Ethos NX5000
產(chǎn)品展商: 日本日立HITACHI
產(chǎn)品文檔: 無相關(guān)文檔
簡單介紹
成都西野供應(yīng)日本日立HITACHI高性能FIB-SEM系統(tǒng)Ethos NX5000
“Ethos”采用日立高新的核心技術(shù)--全球**的高亮度冷場發(fā)射電子槍及新研發(fā)的電磁復(fù)合透鏡�,不但可以在低加速電壓下實現(xiàn)高分辨觀察,還可以在FIB加工時實現(xiàn)實時觀察����。
成都西野供應(yīng)日本日立HITACHI高性能FIB-SEM系統(tǒng)Ethos NX5000
成都西野供應(yīng)日本日立HITACHI高性能FIB-SEM系統(tǒng)Ethos NX5000
的詳細(xì)介紹
核心理念
1. 搭載兩種透鏡模式的高性能SEM鏡筒
-
HR模式下可實現(xiàn)高分辨觀察(半內(nèi)透鏡)
-
FF模式下可實現(xiàn)高精度加工終點檢測(Timesharing Mode)
2. 高通量加工
-
可通過高電流密度FIB實現(xiàn)快速加工( 大束流100nA)
-
用戶可根據(jù)自身需求設(shè)定加工步驟
3. Micro Sampling System*3
-
運用ACE技術(shù)(加工位置調(diào)整)抑制Curtaining效應(yīng)
-
控制離子束的入射角度,制備厚度均勻的薄膜樣品
4. 實現(xiàn)低損傷加工的Triple Beam System*3
-
采用低加速(Ar/Xe)離子束��,實現(xiàn)低損傷加工
-
去除鎵污染
5. 樣品倉與樣品臺適用于各種樣品分析
-
多接口樣品倉(大小接口)
-
超大防振樣品臺(150 mm□)
-
*3
-
選配
高性能SEM鏡筒
Ethos搭載的SEM配有兩種透鏡模式���。HR模式可將樣品置于透鏡磁場之中�����,實現(xiàn)樣品的高分辨觀察���。FF模式可在 短10nsec內(nèi)切換FIB照射與SEM觀察�。用戶可在高速幀頻下觀察SEM圖像的同時��,進(jìn)行FIB加工���,因此��,可輕松判斷截面的加工終點����。NX5000采用電磁復(fù)合透鏡���,即使在FF模式下也可保持高分辨觀察�。
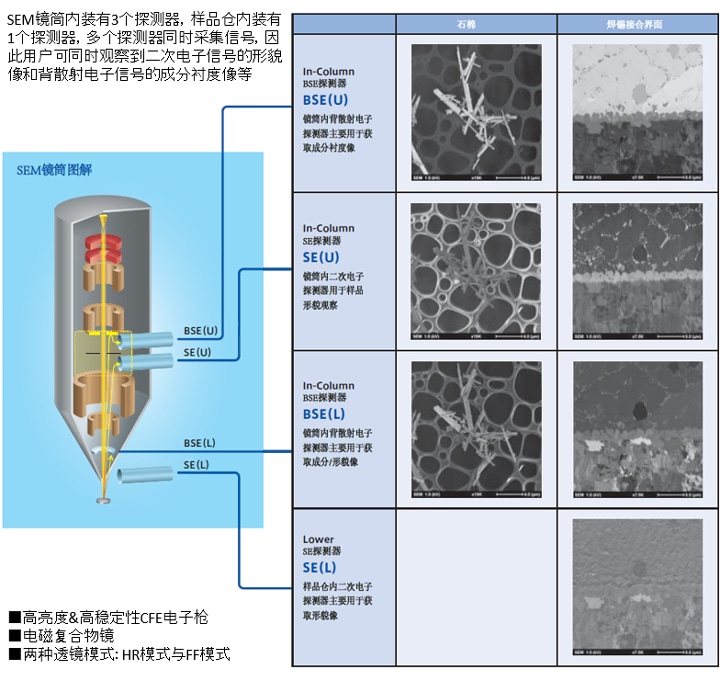
高分辨SEM觀察實例
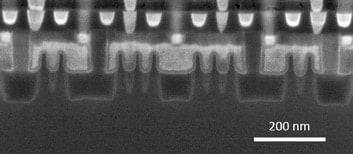
Fin-FET 14 nm device
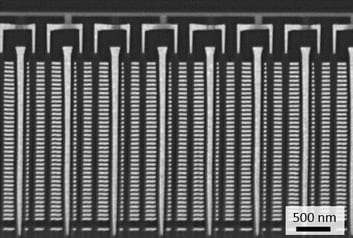
3D-NAND device
高性能FIB鏡筒
通過高電流密度FIB可實現(xiàn)快速加工�、廣域加工�、多處自動加工等
分時掃描模式
在FIB、Ar/Xe離子束照射時�,可實時或分時觀察SEM圖像
■ 分時掃描模式可在 適當(dāng)?shù)奈恢猛V辜庸?br />
■ Cut & See模式可實現(xiàn)高分辨SEM觀察
■ 實時加工模式是加工時間優(yōu)先的FIB加工模式
采用Cut & See模式可實現(xiàn)三維重構(gòu)
FOV:20 μm
Cut & See:200張
Slice pitch:20 nm
SEM加速電壓:1.5 kV
固體氧化物燃料電池的燃料極(Ni-YSZ)
樣品提供:東京大學(xué) 生產(chǎn)技術(shù)研究所
鹿園直毅 教授
抑制FIB加工損傷的高質(zhì)量TEM樣品制備
采用低加速氬離子束以及高電流密度FIB,可實現(xiàn)快速加工����、廣域加工以及多處自動加工等
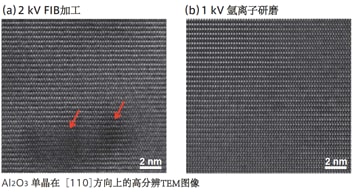
在2kV低加速電壓下進(jìn)行FIB加工時����,觀察Ga+離子照射造成的樣品損傷(紅色箭頭)(圖a)
然后����,在1kV低加速電壓下進(jìn)行氬離子研磨,消除FIB加工產(chǎn)生的損傷層后����,可以清晰觀察到晶格像。
Triple Beam System(氬氣/氙氣)
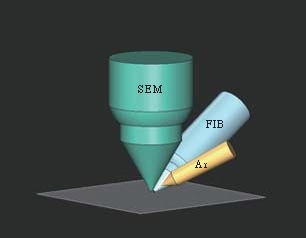
在制備極薄樣品時���,必須采用廣域且低損傷的加工方法��。
Ethos采用樣品加工位置調(diào)整與低加速氬離子束精加工相結(jié)合的ACE技術(shù)��,可制備出高質(zhì)量的TEM薄膜樣品��。
ACE: Anti Curtaining Effect
GUI設(shè)計進(jìn)一步提升了視覺美觀和響應(yīng)速度
4種信號可供選擇
■ In-Column探測器(SED×1�、BSE×2)與樣品倉SE探測器可同時采集信號
■ 搭載各SEM光學(xué)系統(tǒng)的Beam條件保存與讀取功能
■ 可根據(jù)不同觀察需求(形貌/成分)�����,選擇 適合的探測器
■ 每種探測器均可實現(xiàn)對比度���、亮度等個性設(shè)置�、保存與輸出
建立多樣化的加工模式與定序
登錄和輸出各種加工模式/觀察條件
■ 拖拽即可簡單建立加工/觀察定序
■ 各加工模式與程序加工均可自由編輯與登錄
■ 可通過輸出當(dāng)前的程序加工,簡單完成加工設(shè)置
■ 可通過讀取當(dāng)前的定序�����,大大簡化重復(fù)操作
■ 可通過復(fù)制并編輯定序���,進(jìn)一步提高擴展性與靈活性
通過運用各種加工模式�,靈活設(shè)置加工范圍
■ 加工模式支持矩形�����、圓形�、三角形、平行四邊形��、傾斜加工�����、Bit-map加工等
■ 應(yīng)用加工支持橫截面加工以及TEM樣品制備
■ Vector Scan*3可根據(jù)向量信息顯示加工范圍��,完成精準(zhǔn)定位�����。而且����,圖像(bmp)轉(zhuǎn)換成向量后,也可繼續(xù)進(jìn)行樣品加工
■ 搭載各種離子束照射位置補償功能(漂移校正功能)����,可實現(xiàn)高精度加工
-
*3
-
選配
超大樣品倉支持各種用途
■ 配置支持高分辨觀察的防振樣品臺
■ 設(shè)置多種接口,可加裝更多的選配附件���,實現(xiàn)多種樣品加工��、觀察以及分析
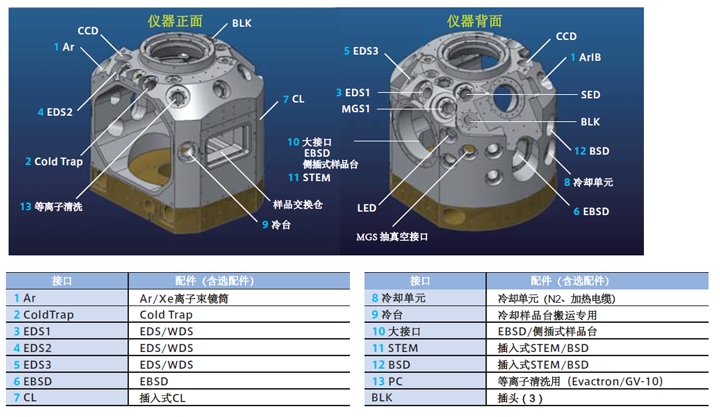
-
|
項目
|
內(nèi)容
|
|
FIB
|
4 nm @ 30 kV�����、60 nm @ 2 kV
|
|
0.5 kV – 30 kV
|
|
0.05 pA – 100 nA
|
|
GA液體金屬離子源
|
|
SEM
|
1.5 nm @ 1 kV����、0.7 nm @ 15 kV
|
|
0.1 kV – 30 kV
|
|
5 pA – 10 nA
|
|
冷場場發(fā)射電子槍
|
|
標(biāo)準(zhǔn)探測器
|
In-Column二次電子探測器 SE(U)
In-Column背散射電子探測器 BSE(U)
In-Column背散射電子探測器 BSE(L)
Chamber二次電子探測器 SE(L)
|
驅(qū)動范圍
(5軸反饋控制)
|
155 mm
|
|
155 mm
|
|
16.5 mm
|
|
0 - 360° 旋轉(zhuǎn)
|
|
-10~59°
|
|
樣品尺寸
|
大直徑 150 mm
|
|
選配
|
Ar/Xe離子束系統(tǒng)
Micro Sampling System
氣體注入系統(tǒng)(雙室或三室貯氣筒)
電動搬運式樣品交換倉
連續(xù)自動加工軟件
連續(xù)A-TEM2
各種樣品桿
EDS(能譜儀)
EBSD(電子背散射衍射)
|
-
-
